Etching of metals which do not have volatile compounds such as Cu and Au cannot be accomplished in RIE Systems; however, physical etching with accelerating Ar ions is possible. Typically, surface is patterned with thick
resist for masking and the energetic ion flux during etching overheats the substrate and the resist. Unless efficient means of removing the heat is found, resist becomes very difficult to remove. NANO-MASTER technology has demonstrated capability of keeping substrate temperature below 50 °C while wafer is rotating to achieve the desired uniformity.
Features:
14.5 SS Cube Ion Beam Chamber
12 cm DC Ion Gun 1000 V, 500 mA , DC Motor Driven SS Shutters
Ion Beam Neutralizer
Ar MFC
Chilled Water Cooled 6 Substrate Platen
Wafer Rotation 3-10 RPM, Vacuum Stepper Motor
Wafer Tilt with a Stepper Motor through Differentially Pumped Rotational Seal
Manual or Auto Wafer Load/Unload
Typical Etch Rates: 20nm/min Cu, 50nm/min Si
+/-5% Etch Uniformity over 4 Area
5×10-6 Torr < 20 minutes < 2x10-7 Torr (2 days) Base Pressure with 500 l/sec Turbo
8x10-8 Torr Base Pressure with 1000 l/sec Turbo Pump
Magnetron Sputtering of SiN4 to Protect Etched Metal Surfaces from Oxidation
PC Controlled with LabVIEW Software
Recipe Driven, Password Protected
Fully Safety Interlocked

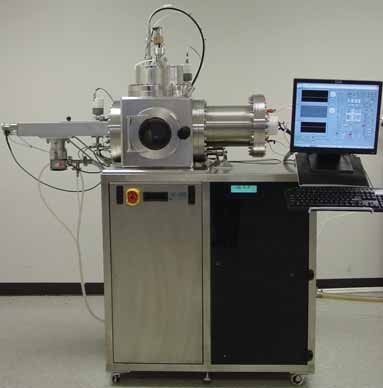

Leave A Comment