NANO-MASTER PECVD systems are capable of depositing high quality SiO2, Si3N4, or DLC films on up to 8 diameter substrate size. To generate plasma, it uses RF shower head electrode or hollow cathode RF plasma source with fractal gas distribution. The platen can be biased with RF or pulsed DC and it is heated resistively or cooled with chilled water circulation. The chamber is evacuated to low 10-7 Torr pressure using 250 l/sec turbomolecular pump backed with 3.5 cfm mechanical pump. Standard unit comes with one inert gas, three reactive gas lines and four mass flow controllers. The planar hollow cathode plasma source with its
unique gas distribution system makes it possible to meet wide range of requirements such as plasma density, uniformity and separate activation of reactive species to cover the broadest possible deposition parameters.
Features:
Stainless Steel or Aluminum Chamber
Vacuum 10-7 Torr Range Base Pressure
RF Shower Head, HCD, ICP or Microwave Plasma Sources
Up to 8 Diameter Substrate Holder
RF Biased Substrate Holder
Water Cooled Platen
Heated Platen up to 800 °C
Heated Gas Lines up to 130 °C
Heated Liquid Delivery System
Corrosive Pump Package
Pneumatically Controlled Valves
PC Controlled with LabVIEW
Recipe Driven, Password Protected
Fully Safety Interlocked
One Carrier Gas and Three Reactive Gases
PC Controlled Mass Flow Controllers
Up to 8 MFCs with Vented Box and Gas Manifolds
Load Lock and Auto Wafer Load/Unload
Applications:
Plasma Induced Surface Modifications
Plasma Cleaning
Plasma Polymerization
SiO2, Si3N4, DLC, other Films
Selective Growth of CNT and Graphene

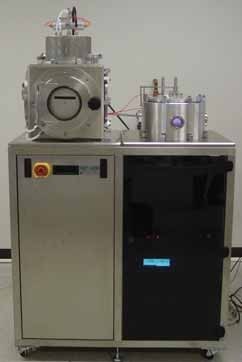

Leave A Comment